Puolijohteiden testaus


Puolijohdemateriaalien kuvantaminen
Tarjoamme korkean resoluution kuvantamista elektronimikroskoopeilla (SEM & TEM) sekä atomivoimamikroskoopilla (AFM). SEM- ja TEM-laitteistoja voidaan täydentää lisäosilla, kuten alkuaineanalyysin mahdollistavalla EDS-detektorilla tai lisätietoa näytteen kiderakenteesta tarjoavalla EBSD-detektorilla. Suuremmista näytekappaleista voidaan tarvittaessa valmistella poikkileikkeet BIB- tai FIB-menetelmillä.
Palveluvalikoimastamme löytyy myös näytettä vahingoittamattomia kuvantamismenetelmiä sisäisten rakenteiden tarkasteluun. Näistä akustinen mikroskopia (SAM) soveltuu erityisen hyvin monikerroksisten kalvojen ja piirilevyjen liitosrajapintojen analysointiin. Myös mikro-CT voi soveltua joillekin puolijohdenäytteille, joskin riittävän korkean resoluution saavuttaminen edellyttää yleensä näytteen leikkaamista.
SEM-EDX-kuvaus
AFM-kuvantaminen sileille pinnoille
HR-TEM-kuvantaminen
STEM-EDX
SEM-kuvantaminen
Näytevalmistelu FIB-tekniikalla
Akustinen mikroskopia (C-SAM)
Mikro-CT- tai nano-CT-kuvaus
Hinnat ilmoitettu ilman arvonlisäveroa.

Alkuainekoostumuksen määritys
Ohutkalvojen ja muiden puolijohdemateriaalien alkuainekoostumus voidaan määrittää näytteen pinnalta sekä eri syvyyksistä. Measurlabs tarjoaa mittauksia muun muassa seuraavilla analyysitekniikoilla:
ToF-ERDA – menetelmällä voidaan määrittää näytteen koostumus kaikkien alkuaineiden sekä vedyn eri isotooppien osalta 0,5 atomiprosentin tarkkuudella.
SIMS – menetelmällä voidaan havaita häviävän pieniä epäpuhtauksia (miljoonas- ja jopa miljardisosia) niin näytteen pinnalta kuin eri syvyyksistä noin 10 mikrometriin asti.
GD-OES – tekniikka soveltuu nopeaan kvantitatiiviseen syvyysprofilointiin ja pystyy havaitsemaan myös kevyitä alkuaineita.
VPD-ICP-MS – soveltuu häviävän pienten metallipitoisuuksien havaitsemiseen piikiekkojen ja ohutkalvojen pinnoilta.
ToF-ERDA-mittaus
Sekundäärinen ionimassaspektrometria (SIMS)
GD-OES-mittaus
VPD ICP-MS
Hinnat ilmoitettu ilman arvonlisäveroa.
Fysikaaliset ominaisuudet
Ohutkalvojen, mikrosirujen ja muiden puolijohdemateriaalien paksuutta, tiheyttä ja karheutta voidaan mitata useilla analyysitekniikoilla. Measurlabs tarjoaa muun muassa karheusmittauksia AFM-menetelmällä, paksuusmittauksia XRR-menetelmällä ja kiderakenteen määritystä GI-XRD- tekniikalla.
AFM - pinnankarheuden määrittäminen
XRR-mittaus ohutkalvoille
Ohutkalvonäytteiden GI-XRD
Ellipsometria
Hinnat ilmoitettu ilman arvonlisäveroa.
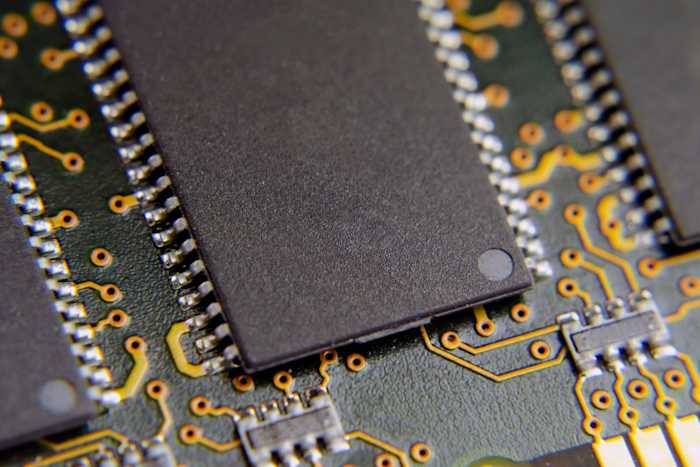
Mikroelektroniikan mekaaninen kestävyys ja lämmönkesto
Tarjoamme useita mittauksia puolijohdemateriaalien, mikroelektroniikan ja muiden sähköisten komponenttien mekaanisen kestävyyden arviointiin. Lisäksi voimme testata komponenttien toimintakykyä matalissa ja korkeissa lämpötiloissa. Seuraavat ovat vain muutamia esimerkkejä saatavilla olevista mittauksista:
Kysy lisää analyysimahdollisuuksista ja pyydä tarjous asiantuntijoiltamme.
Asiantuntevaa asiakaspalvelua
Kun tilaat tarvitsemasi puolijohteiden testauspalvelut Measurlabsilta, saat käyttöösi laajan analyysivalikoiman helposti yhdestä paikasta, selkeät testiraportit sekä tukea sopivimman mittaustekniikan valintaan testausalan asiantuntijoilta. Tee tarjouspyyntö tai kysy lisätietoja alta löytyvällä lomakkeella.
Tarjouspyyntö
Vastaamme viesteihin yhdessä arkipäivässä.
Onko sinulla kysymyksiä tai tarvitsetko apua? Lähetä meille sähköpostia info@measurlabs.com tai soita myyjillemme.
