XPS-analyysi
Röntgenfotoelektronispektroskopia (XPS) on tekniikka, jolla määritetään materiaalien pintojen alkuainekoostumusta ja atomien kemiallisia sidostiloja. Menetelmää käytetään laajasti eri teollisuudenaloilla tutkittaessa materiaaleja puolijohteista polymeereihin ja katalyytteihin.

Tutustu XPS-mittauksiin tarkemmin
XPS-syvyysprofilointi
XPS-mittaus
Hinnat ilmoitettu ilman arvonlisäveroa.
Mikä XPS on ja mihin sitä käytetään?
Röntgenfotoelektronispektroskopia (XPS) on pinta-analyysitekniikka, jota käytetään määrittämään alkuainekoostumusta ja sitä, miten atomit ovat sitoutuneet toisiinsa. Se voi havaita kaikki alkuaineet vetyä (H) ja heliumia (He) lukuun ottamatta. XPS on erittäin pintaherkkä, ja sen tyypillinen analysointisyvyys on 3–9 nanometriä (noin 20-60 atomikerrosta), tai 300 nm saakka käytettäessä syvyysprofilointia. Tyypillinen detektioraja alkuaineille on 0.1–1 atomi%, riipuen alkuaineesta ja näytetyypistä.
XPS tarjoaa kahdentyyppistä avaintietoa:
Alkuainekoostumus: Mitä alkuaineita näytteen pinnalla on ja mitkä ovat niiden pitoisuudet.
Kemialliset tilat: Miten kyseiset alkuaineet ovat sitoutuneet (esim. onko hiili C–C-, C–O- vai C=O-sidoksessa).
Koska XPS:ää voidaan käyttää lähes minkä tahansa kiinteän ja kuivan materiaalin karakterisointiin, tekniikkaa käytetään rutiininomaisesti monenlaisten materiaalien tutkimiseen, kuten puolijohteet, metallit, tekniset muovit, pinnoitteet, katalyytit ja kuidut. Yleisiä sovelluksia ovat mm. ohutkalvojen atomikoostumuksen määrittäminen, katalyyttitutkimukset, tartuntaominaisuudet, kostutettavuus ja korroosio.
Miten XPS toimii?
XPS-mittauksessa näytettä pommitetaan röntgensäteillä, joilla on riittävästi energiaa irrottamaan elektroneja materiaalin pinnan atomeista. Näiden emittoituvien elektronien (joita kutsutaan fotoelektroneiksi) energiat ovat kvantittuneet ja ne ovat ominaisia niille atomeille ja niiden muodostamille kemiallisille sidoksille, joista fotoelektronit ovat peräisin. Mittaamalla emittoituneiden fotoelektronien lukumäärää ja energioita tuotetaan XPS-spektri. Näistä tiedoista voidaan määrittää seuraavat asiat:
Mitä alkuaineita näyte sisältää
Alkuaineiden määrät
Niiden kemialliset ympäristöt (esim. sidosten tyypit)
Miten nämä ominaisuudet muuttuvat syvyyden mukaan maksimissa 300 nm syvyyten (käytettäessä syvyysprofilointia, lisätietoja alla)
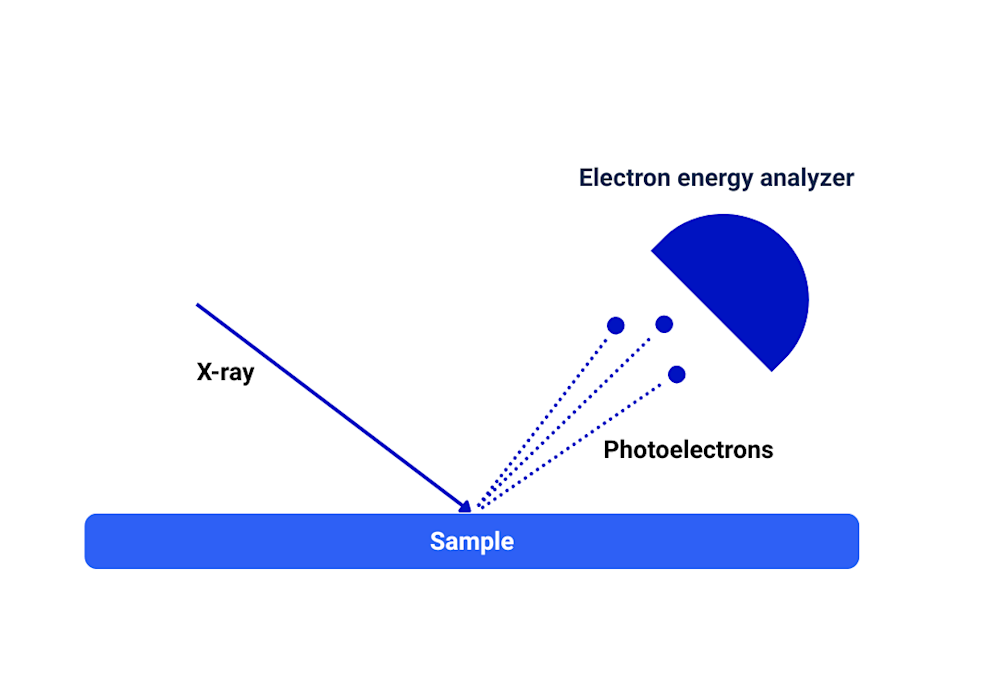
XPS-syvyysprofilointi
Vaikka XPS on hyvin pintaherkkä ja analysointisyvyys rajoittuu vain noin 3–9 nm:iin, syvyysprofilointi voidaan tehdä suorittamalla ensin XPS-mittaus, poistamalla sitten tunnettu määrä materiaalia varattujen ionien etsauksella (prosessi nimeltä sputterointi) ja suorittamalla sitten uusi XPS-analyysi. Toistamalla tätä sykliä monta kertaa saadaan aikaan atomien syvyysprofiileja.
Ionisyövytyksen (jäljempänä "sputterointi") aikana tutkittavaa materiaalia pommitetaan energisillä varatuilla ioneilla, jotka etsaavat näytteen pintaa. Argonioneja (Ar+), argonklusteri-ioneja (Arn+) tai Buckminsterfullereeniklusteri C60+ ioneja käytetään yleisesti materiaalin sputterointiin. Argonionia käytetään yleisesti metallisten ja keraamisten materiaalien syvyysprofilointiin, jotka ovat resistantteja sputteroinnille, kun taas argonklusteri- tai Buckminsterfullereenisputterointia käytetään, kun näytemateriaali on orgaanista tai muuten herkkää sputteroinnille. Tyypillisesti sputterointiin käytetään ioneja, joiden energia on 0,5–5 keV, riippuen halutusta etsausnopeudesta ja näytemateriaalista.
Toistamalla XPS-mittaus- ja sputterointivaiheita on mahdollista tehdä syvyysprofilointi 1–300 nanometrin paksuisille pintakerroksille kohtuullisilla mittausajoilla. Erityistapauksissa syvyysprofilointi voidaan tehdä jopa mikrometrin syvyyteen.
Näytevaatimukset ja valmistelu
Näytteiden on oltava kuivia ja vapaita haihtuvista yhdisteistä, koska mittaukset suoritetaan yleisimmin ultrakorkeassa tyhjiössä (UHV). Sopivia näytetyyppejä ovat:
Kiinteät aineet (esim. bulkkimateriaalit ja kiinteät katalyytit)
Jauheet & kuidut
Pinnoitteet, ohutkalvot, yms.
Tyypillisesti suositeltava näytekoko on noin 1 × 1 cm, vaikka suurempia tai pienempiä näytteitä voidaan usein käsitellä. Erityisiä näytteenvalmisteluvaiheita ei vaadita kuiville materiaalinäyteille. Märät näytteet vaativat kuivauksen ennen mittausta. Jauhenäytteet vaativat kiinnittämistä johtavalle hiiliteipille tai metallifoliolle (esim. indium).
XPS-variaatiot
Tyypillisesti XPS-mittaukset tehdään laboratoriomittakaavan laitteilla, jotka tarjoavat kustannustehokkuutta ja mittaukset saadaan suoritettua nopeasti näytteiden vastaanoton jälkeen. Nämä laitteet käyttävät kiinteän energian röntgenlähteitä (alumiini, magnesium, kromi jne.), joiden säteen intensiteetti on rajallinen. Tämä tarkoittaa, että röntgensäteen energiaa ei voida muuttaa analysointisyvyyden säätämiseksi, ja saavutettu spektrinen resoluutio ja signaali-kohinasuhde ovat vain kohtalaisia.
Laboratoriomittakaavan XPS:n rajoitukset ovat yleensä merkityksettömiä, kun kiinnostuksen kohteena olevat näytteet koostuvat vain muutamasta kemiallisesti erilaisesta faasista ja tavoitteena on tutkia pinnan muutaman ylimmän nanometrin kerrosta. Rajoitukset tulevat merkityksellisiksi analysoitaessa näytteitä, jotka koostuvat lukuisista eri faaseista, joiden XPS-piikit (emittoituneiden fotoelektronien energiat) ovat lähellä toisiaan, tai kun tavoitellaan hyvin pientä (<3 nm) tai suurta (>10 nm) analysointisyvyyttä.
Synkrotroni-XPS tarjoaa merkittävästi korkeamman intensiteetin primäärisen röntgensäteen kuin laboratoriomittakaavan laite. Tämän seurauksena synkrotronipohjaisen XPS:n spektrinen resoluutio on huomattavasti parempi kuin laboratoriomittakaavan laitteen. Primäärisen röntgensäteen energiaa voidaan säätää synkrotroniasetelmassa. Tämä mahdollistaa analysointisyvyyden säätämisen muutamasta nanometristä jopa 30 nm:iin tai enemmän. Näiden etujen vuoksi synkrotronipohjaista XPS:ää käytetään usein, kun näytteet koostuvat useista faaseista ja halutaan erittäin yksityiskohtaista tietoa pintatomien sidoksista. Näillä eduilla on myös haittapuolensa; synkrotroni-XPS:n läpimenoajat ovat tyypillisesti hieman pidempiä ja hinnat hieman korkeampia verrattuna laboratoriomittakaavan XPS:ään.
Vaikka useimmat XPS-mittaukset suoritetaan ultrakorkeassa tyhjiössä, mikä estää haihtuvia yhdisteitä sisältävien näytteiden karakterisoinnin, lähes ympäristönpaineen XPS (NAP-XPS) -laitteistot, joita on saatavilla pääasiassa synkrotronilaitoksissa, mahdollistavat kemiallisten muutosten mittaamisen näytteen pinnalla eri annosteltujen kaasujen (H2O, N2, jne.) läsnäollessa korkeammissa paineissa (noin 30 mbar). Tämä mahdollistaa katalyysireaktioiden, pinta-adsorption, korroosion in-situ-tutkimukset sekä pintojen välituotteiden karakterisoinnin ALD-prosessien alkuvaiheissa.
Rajoitukset ja täydentävät menetelmät
Vaikka XPS:ää voidaan käyttää monenlaisten kiinteiden materiaalien tutkimiseen, sillä on tiettyjä rajoituksia. Metelmä on pintaherkkä, eli jos koko näytteen alkuainepitoisuudet halutaan selvittää, XRF on parempi vaihtoehto. XPS:n alkuainekohtainen deterktioraja on tyypillisesti noin 0.1-1 atomiprosenttia. Siksi menetelmä ei sovellu alhaisten alkuainepitoisuuksien analysointiin, vaan herkempiä menetelmiä, kuten VPD-ICP-MS, TXRF, SIMS, Tof-SIMS tai ATD-GC-MS tulee hyödyntää. Näiden rajoitusten lisäksi XPS ei havaitse vetyä (H). Vetypitoisuuksien analysoimiseksi tulee käyttää ToF-ERDA- tai SIMS-tekniikoita.
Tarvitsetko XPS-analyyseja?
Measurlabs tarjoaa XPS-mittauksia monentyyppisille näytteille kuten ohutkalvoille, metalleille ja orgaanisille materiaaleille. Kumppanilaboratorioverkostomme kautta meillä on käytössämme useita laitteistoja (lisätietoja XPS-palvelusivullamme, myös synkrotroni XPS on saatavilla), ja pystymme siten hyvin vastaamaan erilaisiin pinta- ja syvyysprofiilianalyyseihin liittyviin vaatimuksiin. Analysoimme tarvittaessa myös suuria näytemääriä nopeasti – ota yhteyttä alla olevan lomakkeen kautta keskustellaksesi asiantuntijoidemme kanssa ja pyytääksesi tarjouksen.
Menetelmän asiantuntija
Soveltuvat näytematriisit
- Katalyytit
- Ohutkalvot (ALD, CVD, PVD jne.)
- Puolijohteet
- Muovit ja muovipinnoitteet
- Metallit
- Lasi
- Kuidut ja kuitukomposiitit
XPS-menetelmän yleisiä käyttötarkoituksia
- Ohutkalvojen atomistoikiometrioiden määrittäminen
- Pintojen hapettumistilan tutkiminen valmistuksen jälkeen
- Katalyyttitutkimukset
- Voiteluaineiden, liimojen ja puhdistusaineiden vaikutusten arviointi
- Epäpuhtauksien tunnistaminen metalli-, muovi-, lasi- ja kuitupinnoilla
- Korroosion, hapettumisen, nitridoinnin ja hiiletyksen vaikutusten tarkastelu
Ota yhteyttä
Vastaamme viesteihin yhdessä arkipäivässä.
Onko sinulla kysymyksiä tai tarvitsetko apua? Lähetä meille sähköpostia info@measurlabs.com tai soita myyjillemme.
Usein kysytyt kysymykset
Measurlabs tarjoaa erilaisia laboratorioanalyyseja tuotekehittäjille ja laatujohtajille. Suoritamme osan analyyseista omassa laboratoriossamme, mutta enimmäkseen ulkoistamme ne huolella valikoiduille kumppanilaboratorioille. Tällä tavoin pystymme lähettämään kunkin näytteen sille sopivimpaan laboratorioon ja tarjoamaan asiakkaillemme korkealaatuisia analyyseja yli tuhannella eri menetelmällä.
Kun otat meihin yhteyttä tarjouspyyntölomakkeella tai sähköpostilla, yksi menetelmäasiantuntijoistamme ottaa mittauksesi hoitaakseen ja vastaa mahdollisiin kysymyksiisi. Saat kirjallisen tarjouksen, jossa on kerrottu mittauksen yksityiskohdat ja osoite, johon voit lähettää näytteet. Me huolehdimme sen jälkeen näytteiden toimittamisesta oikeisiin laboratorioihin ja kirjoitamme tuloksista sinulle selkeän mittausraportin.
Näytteet toimitetaan laboratorioomme yleensä lähetillä. Varmista yksityiskohdat asiantuntijamme kanssa ennen näytteiden lähettämistä.
