TXRF-analyysi
Totaaliheijastus-röntgenfluoresenssi eli TXRF (eng. total reflection X-ray fluorescence) on analyysitekniikka, jolla voidaan mitata hyvin pieniä alkuainemääriä muun muassa ohutkalvojen pinnoilta. TXRF-menetelmää käytetään puolijohdeteollisuudessa epäpuhtauksien havaitsemiseen prosessoitavien kiekkojen pinnoilta.

Mihin TXRF-analyysiä käytetään?
TXRF-menetelmää käytetään pääasiassa erilaisten wafereiden pinnalla esiintyvän metallikontaminaatioiden tutkimiseen puolijohdeteollisuudessa. Menetelmällä voidaan havaita alkuaineita natriumista (Na) uraaniin (U) pitoisuuksina, jotka vaihtelevat välillä 109 - 1012 atomia neliösenttimetriä kohden, minkä johdosta TXRF on yksi herkimmistä menetelmistä alkuainekontaminaation tutkimiseen.
Miten TXRF toimii?
TXRF:n toimintaperiaate ja siihen perustuva röntgenfluoresenssi on esitetty kuvaajassa 1. TXRF-analyysi aloitetaan suuntaamalla monokromaattinen röntgensäde näytteen pintaa kohden hyvin loivassa kulmassa, yleensä alle 0,5° pinnan tasoon nähden. Tällöin säde tunkeutuu vain näytteen pintaan (~5 nm), eivätkä näytteen alemmat rakenteet vaikuta pintatutkimukseen.
Kun röntgensäde osuu pintaan, se virittää atomeja poistamalla matalan energiatason elektroneja sisemmistä elektronikuorista. Tällöin ulomman kuoren korkeampi-energinen elektroni putoaa täyttämään tyhjän paikan, ja samalla vapautuu toissijainen röntgensäde (röntgenfluoresenssi). Näiden toissijaisten röntgensäteiden energiat ovat ominaisia alkuaineille, joista ne ovat peräisin. Säteiden havaitseminen energia-dispersiivisellä detektorilla mahdollistaa näytteen alkuaineiden ja niiden pitoisuuksien määrittämisen.
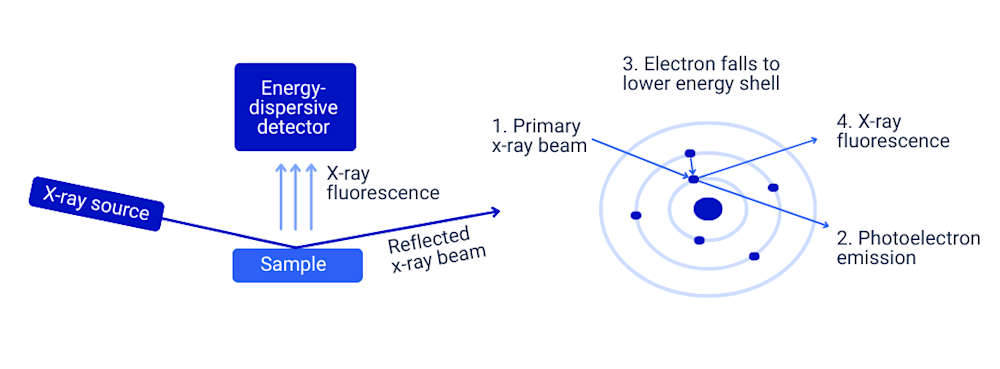
Solvetuvat näytteet ja niistä saatavat tulokset
TXRF soveltuu paljaille ja pinnoitetuille kiekoille, joiden koko on 100–300 mm. Käytännössä kaikki yleisimmät kiekkomateriaalit, kuten Si, SiC, GaAs, GaN, InP ja lasi, soveltuvat TXRF-analyysiin. Tärkein vaatimus TXRF:lle on sileä pinta, joten kiekkoja, joihin on kasvatettu ohutkalvoja tavanomaisilla menetelmillä, kuten ALD, CVD tai PVD, voidaan analysoida.
Tyypillisessä TXRF-mittauksessa yhdestä kiekosta mitataan 40–300 yksittäistä pistettä, ja epäpuhtauksina esiintyvien alkuaineiden pitoisuudet esitetään kaksiulotteisina lämpökarttoina (Kuvaaja 2).

Huomioitavaa ja täydentävät menetelmät
Koska TXRF on äärimmäisen herkkä menetelmä alkuaine-epäpuhtauksien havaitsemiseksi, kaikki analyysiin toimitettavat näytteet on pakattava puhdastilassa ja pakkaus on suljettava ilmatiiviisti kuljetuksen aikaisen kontaminaation estämiseksi.
Vaikka TXRF on erittäin tehokas menetelmä metallisten epäpuhtauksien määritykseen kiekoilla, ja kartoitus tarjoaa ainutlaatuisia mahdollisuuksia kontaminaatiolähteiden tunnistamiseen tuotantoprosessissa, on se myös yksi kalleimmista kontaminaatioanalyysimenetelmistä. Yhden kiekon epäpuhtauskartoitus maksaa tyypillisesti 1000–10 000 euroa riippuen kiekon koosta, mitattavien pisteiden määrästä ja näytteiden lukumäärästä.
Mikäli haetaan rutiinimenetelmää kiekkojen pinnan alkuainekontaminaation tutkimiseen, VPD-ICP-MS (vapor phase decomposition – inductively coupled plasma – mass spectrometry) tarjoaa kustannustehokkaan vaihtoehdon TXRF:lle ja usein vielä matalammilla havaitsemisrajoilla. VPD-ICP-MS ei kuitenkaan tarjoa sijaintitietoa kontaminaatiosta. Molemmat, TXRF ja VPD-ICP-MS, ovat pintaherkkä menetelmiä, joten syvyysprofiilin tutkimiseen tarvitaan muita menetelmiä, kuten SIMS (secondary ion mass spectrometry). Orgaanisten epäpuhtauksien tutkimiseen soveltuu parhaiten ATD GC-MS (automated thermal desorption – gas chromatography – mass spectrometry)
TXRF vs. XRF
Pohjimmiltaan perinteinen röntgenfluoresenssi (XRF) ja TXRF toimivat samalla periaatteella. Erottavana tekijänä on TXRF:n säteen matala tulokulma, joka vähentää sironneiden ja absorboituneiden röntgensäteiden määrää ja maksimoi fluoresenssin. Tämä parantaa signaali-kohinasuhdetta ja mahdollistaa merkittävästi perinteistä XRF-analyysia suuremman herkkyyden.
TXRF:n haittapuolia verrattuna tavalliseen XRF:ään ovat laitteiston korkea hinta ja suuri koko. Lisäksi TXRF vaatii täysin sileitä ja puhtaita näytteitä ilman hiukkasepäpuhtauksia, kun taas XRF:llä voidaan analysoida lähes minkälaisia kiinteitä tai nestemäisiä näytteitä tahansa ilman erityisiä sileys- tai puhtausvaatimuksia. Näiden erojen vuoksi XRF soveltuu monenlaisten näytteiden alkuainekoostumuksen ja epäpuhtauksien tutkimiseen vähäisellä näytevalmistelulla, kun taas TXRF on käytännössä rajoittunut puolijohdeteollisuuden sovelluksiin.
Tarvitsetko TXRF-analyysejä?
Measurlabs tarjoaa niin TXRF-mittauksia kuin lukuisia muita menetelmiä (mm. VPD-ICP-MS ja ToF-SIMS) ohutkalvojen ja kiekkojen kontaminaatioanalyysiin. Käsittelemme suuretkin näyte-erät tehokkaasti ja järjestämme analyysit tarvittaessa pika-aikataululla. Laajaan kumppanilaboratorioverkostoon perustuvan toimintamallimme ansiosta saat kaikki tarvitsemasi analyysit helposti yhdestä osoitteesta. Tee tarjouspyyntö alla olevan lomakkeen kautta – asiantuntijamme vastaavat viesteihin yhden arkipäivän kuluessa.
Menetelmän asiantuntija
Soveltuvat näytematriisit
- Waferit (Si, SiC, GaAs, GaN, InP, yms.)
- Ohutkalvot
- Puolijohteet
TXRF-menetelmän yleisiä käyttötarkoituksia
- Epäpuhtauksien tunnistus
- Metallikontaminaatioden tutkiminen
Ota yhteyttä
Vastaamme viesteihin yhdessä arkipäivässä.
Onko sinulla kysymyksiä tai tarvitsetko apua? Lähetä meille sähköpostia info@measurlabs.com tai soita myyjillemme.
Usein kysytyt kysymykset
Measurlabs tarjoaa erilaisia laboratorioanalyyseja tuotekehittäjille ja laatujohtajille. Suoritamme osan analyyseista omassa laboratoriossamme, mutta enimmäkseen ulkoistamme ne huolella valikoiduille kumppanilaboratorioille. Tällä tavoin pystymme lähettämään kunkin näytteen sille sopivimpaan laboratorioon ja tarjoamaan asiakkaillemme korkealaatuisia analyyseja yli tuhannella eri menetelmällä.
Kun otat meihin yhteyttä tarjouspyyntölomakkeella tai sähköpostilla, yksi menetelmäasiantuntijoistamme ottaa mittauksesi hoitaakseen ja vastaa mahdollisiin kysymyksiisi. Saat kirjallisen tarjouksen, jossa on kerrottu mittauksen yksityiskohdat ja osoite, johon voit lähettää näytteet. Me huolehdimme sen jälkeen näytteiden toimittamisesta oikeisiin laboratorioihin ja kirjoitamme tuloksista sinulle selkeän mittausraportin.
Näytteet toimitetaan laboratorioomme yleensä lähetillä. Varmista yksityiskohdat asiantuntijamme kanssa ennen näytteiden lähettämistä.
