XRR-analyysi
Röntgenheijastavuus (eng. X-ray reflectivity eli XRR) on analyysitekniikka yksi- ja monikerroksisten ohutkalvojen ja pinnoitteiden rakenteellisten ominaisuuksien määrittämiseen. XRR soveltuu yksi- tai monikerroksisten pintarakenteiden karakterisoimiseen, sillä se tarjoaa tietoa näytemateriaalin yksittäisten kerrosten paksuudesta ja tiheydestä sekä kerrosten välisten rajapintojen karheudesta.
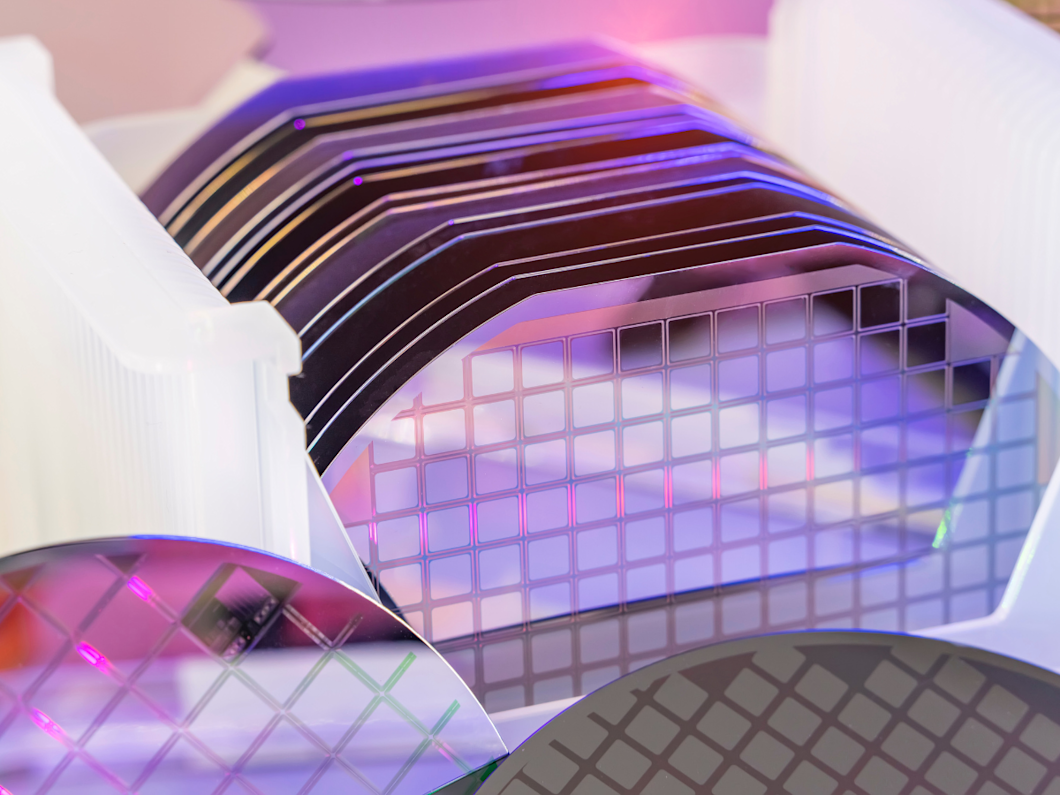
Tilaa XRR-analyysit Measurlabsilta
XRR-mittaus ohutkalvoille
Ohutkalvonäytteiden GI-XRD + XRR
Hinnat ilmoitettu ilman arvonlisäveroa.
XRR-analyysin käyttötarkoitukset
Röntgenheijastavuutta (X-ray reflectivity, XRR), joka tunnetaan myös nimillä spekulaarinen röntgenheijastavuus (X-ray specular reflectivity) ja röntgenreflektometria (X-ray reflectometry), käytetään ohutkalvojen ominaisuuksien määrittämiseen analysoimalla näytteen heijastamia röntgensäteitä. XRR:n avulla on mahdollista määrittää erilaisten ohutkalvojen paksuus, tiheys ja karheus.
Tekniikka soveltuu monenlaisten ohutkalvojen karakterisointiin, mukaan lukien metallioksidit, metallit ja orgaaniset kalvot. Tutkittavat kalvot voivat olla valmistettu eri menetelmillä, kuten kemiallinen kaasufaasikerrostus (CVD), atomikerroskasvatus (ALD), fysikaalinen kaasufaasikerrostus (PVD) ja muut vastaavat tekniikat. Sekä yksi että monikerroksiset ohutkalvot millä tahansa tyypillisellä substraatilla, kuten pii (Si), galliumnitridi (GaN), piikarbid (SiC), galliumarsenidi (GaAs) tai indiumfosfidi (InP) -wafereilla soveltuvat XRR analyysiin. Sekä kiteiset että amorfistet ohutkalvot voidaan karakterisoida XRR:lla.
Esimerkki XRR-tuloksista on esitetty taulukossa 1. Tutkittu näyte on Al2O3-ohutkalvo, joka on kasvatettu piikiekolle, jonka pinnalla on luonnollinen SiO2-oksidikerros. Molempien kerrosten paksuus, tiheys ja pinnan karheus määritettiin.

XRR:n avulla kalvojen paksuus voidaan yleensä määrittää luotettavasti muutamasta nanometristä 150 nanometriin asti. Yli 150 nm paksuissa kalvoissa tiheyden ja pinnan karheuden mittaus on edelleen tarkkaa, mutta paksuuden määrittäminen muuttuu epätarkemmaksi ja edelleen mahdottomaksi kalvonpaksuuden kasvaessa. Sileä pinta parantaa XRR-mittausten tarkkuutta, ja näytteet, joiden RMS-karheus on alle 5 nm, katsotaan yleisesti hyvin analyysiin soveltuviksi.
XRR toimintaperiaate
XRR-analyysissä näytteeseen kohdistetaan röntgensäteitä hyvin pienessä tulokulmassa. Kun röntgensäteet osuvat näytteeseen, ne vuorovaikuttavat materiaalin elektronien kanssa ja heijastuvat pinnasta. XRR-laite mittaa näiden heijastuneiden röntgensäteiden intensiteettiä samalla kun tulo- ja detektiokulmia muutetaan, jolloin saadaan heijastavuuden kuvaaja kulman funktiona (Kuvaaja 1).
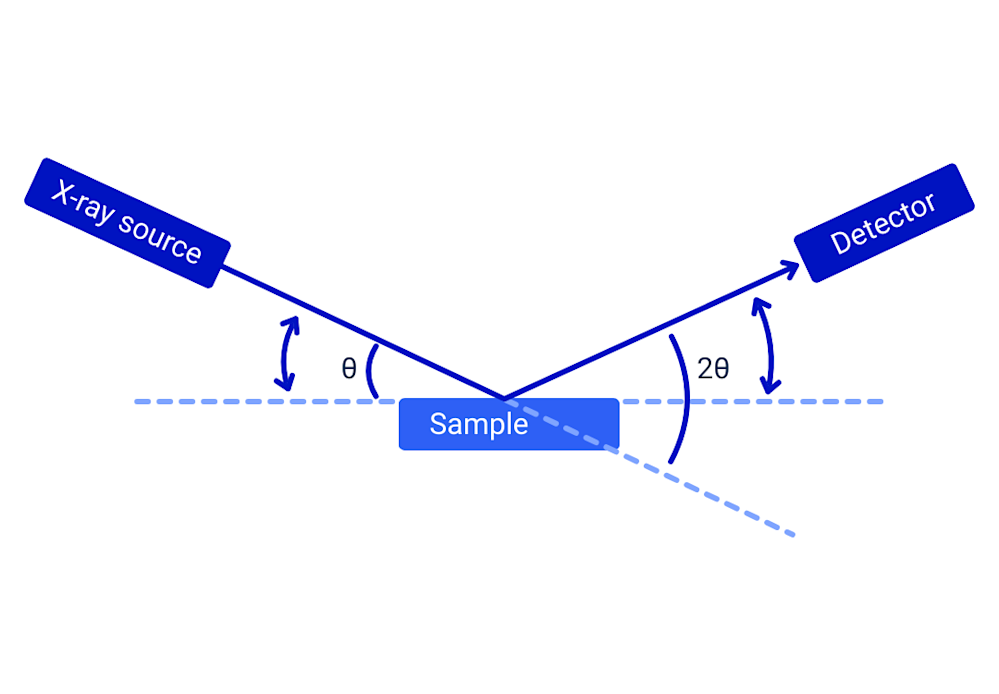
Jokaisella materiaalilla on sille ominainen kriittinen kulma, jonka määrittää sen elektronitiheys. Tämän kulman alapuolella tulevat röntgensäteet pääasiassa kokonaisheijastuvat ja tunkeutuvat materiaaliin vain vähän (muutaman nanometrin). Kriittisen kulman yläpuolella tunkeutumissyvyys kasvaa merkittävästi, samalla kun heijastuneiden röntgensäteiden intensiteetti laskee jyrkästi.
Näytteissä, joissa on ohutkalvoja tai pinnoitteita substraatilla (alustalla), röntgensäteet heijastuvat paitsi päällimmäisestä pinnasta myös eri kerrosten välisiltä rajapinnoilta (kaikkialta, missä materiaalin tiheys muuttuu). Koska syvemmiltä rajapinnoilta heijastuvat röntgensäteet kulkevat pidemmän matkan, ne interferoivat ylemmiltä pinnoilta heijastuneiden säteiden kanssa. Tämä interferenssi, jossa röntgenaallot joko vahvistavat tai kumoavat toisensa, luo luonteenomaisen oskillaatiokuvion mitattuun heijastavuusdataan (Kuvaaja 2).

XRR kuvaajasta saadaan määritettyä seuraavat ominaisuudet:
Tiheys - Määritetään kriittisen kulman sijainnista.
Kerrospaksuus - Määritetään interferenssioskillaatioiden (Kiessigin raitojen) taajuudesta.
Pinnan ja rajapintojen karheus - Päätellään siitä, kuinka nopeasti kokonaisheijastavuus laskee kulman kasvaessa ja kuinka vaimentuneita oskillaatiot ovat. Sileämpi pinta johtaa jyrkempään laskuun kriittisen kulman jälkeen ja selkeämpiin oskillaatioihin, kun taas karheus aiheuttaa loivemman laskun ja heikompia oskillaatioita.
Measurlabs tarjoaa korkealaatuisia XRR-analyysejä kilpailukykyiseen hintaan
Käytössämme on useita laitteita (katso lisää XRR-palvelusivulta), ja käsittelemme myös suurien näytemäärien tilaukset tehokkaasti. Asiantuntijamme ovat aina valmiina auttamaan, jos sinulla on kysyttävää näytteisiisi tai menetelmän soveltuvuuteen liittyen.
Ota yhteyttä alla olevan lomakkeen kautta, niin teemme sinulle räätäläidyn tarjouksen – huomaathan että saat meiltä XRR:n lisäksi myös muut puolijohdemateriaalien kehitykseen ja laadunvalontaan liittyvät analyysit!
Menetelmän asiantuntija
Soveltuvat näytematriisit
- Puolijohteet
- Optiset materiaalit
- Ohutkalvot Si, GaN, SiC, GaAs tai InP substraateilla
- ALD ohutkalvot
- CVD ohutkalvot
- PVD ohutkalvot
XRR-analyysin tyypillisiä käyttökohteita
- Ohuiden materiaalien sekä monikerroskalvojen yksittäisten kerrosten paksuuden, tiheyden ja karkeuden määrittäminen
- Materiaalien pinnan ja mahdollisten kerrosten rajapintojen ominaisuuksien tutkiminen
- Erittäin ohuiden yksittäisten kalvojen ja pinnoitteiden rakenteellisten ominaisuuksien analysoiminen
- Tutkimus ja tuotekehitys sekä laadunvalvonta ja tuotantoprosessien optimointi
Ota yhteyttä
Vastaamme viesteihin yhdessä arkipäivässä.
Onko sinulla kysymyksiä tai tarvitsetko apua? Lähetä meille sähköpostia info@measurlabs.com tai soita myyjillemme.
Usein kysytyt kysymykset
XRR:ää käytetään yleensä yhdestä kalvosta tai monien erilaisten kalvojen kerroksista koostuvien materiaalien rakenteellisten ominaisuuksien tutkimiseen. Materiaalin yksittäisten kerrosten parametrit, kuten paksuus ja tiheys, voidaan määrittää. Lisäksi sekä materiaalin pinnan, että sen eri kerrosten rajapintojen karkeus voidaan selvittää. Mitatusta datasta voidaan päätellä myös rajapintojen tai kerrosten sivurakenteen korrelaatio-ominaisuudet.
Tämä materiaalien ominaisuuksien selvittäminen voi olla valtava apu niiden tutkimuksessa ja tuotekehityksessä sekä tuotantoprosessien optimoinnissa ja laadunvalvonnassa.
Näytteen alkuainekoostumusta ei voida määrittää XRR:llä, joten alkuaineet, joista materiaali koostuu tulisi selvittää etukäteen. Materiaalin lisäksi sen arvioitu paksuus täytyy myös tietää ennen analyysiä, sillä vain alle 5 000 nanometrin paksuisia kerroksia voidaan tutkia.
Mahdollisia sivuttaisia (lateraalisia) epähomogeenisuuksia ei voida havaita XRR:llä, joten tällä tekniikalla tuotettu näytteen malli ei ota huomioon näitä ominaisuuksia.
Ohutkalvojen, kerrosten ja pinnoitteiden hiukkastason ominaisuuksia, kuten kiderakennetta ja hilan parametreja, ei voida analysoida XRR:llä. Sen sijaan ohutkalvoröntgendiffraktio (GIXRD) on sopiva menetelmä tähän tarkoitukseen.
XRR:llä analysoitavat materiaalit voivat olla esimerkiksi puolijohteita, magneettisia tai optisia. XRR toimii parhaiten, kun näyte on sileä, tasainen ja litteä ja sen karkeus on alle 2 nanometriä. Tutkittavan kalvon kokonaispaksuuden on oltava alle 5 000 nanometriä.
Analysoitavat näytteet voivat koostua yhdestä hyvin ohuesta kerroksesta tai monista ohuista kerroksista ja niillä voi olla erilaisia pinnoitteita. Yksittäiset kalvot taas voivat koostua joko yksikiteisistä, monikiteisistä tai amorfisista aineista.
Measurlabs tarjoaa erilaisia laboratorioanalyyseja tuotekehittäjille ja laatujohtajille. Suoritamme osan analyyseista omassa laboratoriossamme, mutta enimmäkseen ulkoistamme ne huolella valikoiduille kumppanilaboratorioille. Tällä tavoin pystymme lähettämään kunkin näytteen sille sopivimpaan laboratorioon ja tarjoamaan asiakkaillemme korkealaatuisia analyyseja yli tuhannella eri menetelmällä.
Kun otat meihin yhteyttä tarjouspyyntölomakkeella tai sähköpostilla, yksi menetelmäasiantuntijoistamme ottaa mittauksesi hoitaakseen ja vastaa mahdollisiin kysymyksiisi. Saat kirjallisen tarjouksen, jossa on kerrottu mittauksen yksityiskohdat ja osoite, johon voit lähettää näytteet. Me huolehdimme sen jälkeen näytteiden toimittamisesta oikeisiin laboratorioihin ja kirjoitamme tuloksista sinulle selkeän mittausraportin.
Näytteet toimitetaan laboratorioomme yleensä lähetillä. Varmista yksityiskohdat asiantuntijamme kanssa ennen näytteiden lähettämistä.
