Halbleiter-Testdienstleistungen


Bildgebende Dienstleistungen
Wir bieten verschiedene Techniken für die hochauflösende Bildgebung von Halbleiterbauelementen und -komponenten an, darunter die folgenden:
Für die Elektronenmikroskopie stehen mehrere zusätzliche Detektoren zur Verfügung, darunter EDX für die simultane Elementaranalyse und EBSD für die Visualisierung von Kristallstrukturen. Querschnittsanalysen sind mit FIB und BIB-Probenpräparation möglich.
REM-EDX-Bildgebung
AFM-Oberflächenabbildung
HR-TEM-Bildgebung
STEM-EDX
REM-Bildgebung
Präparation mittels fokussiertem Ionenstrahl (FIB)
Akustische Rastermikroskopie (C‑SAM)
Röntgen-Computertomographie (Mikro- und Nano-CT-Scan)
Preise ohne MwSt.

Elementaranalyse
Measurlabs bietet mehrere Optionen zur Bestimmung der Elementzusammensetzung von Dünnschichten und Wafern, sowohl an der Oberfläche als auch als Funktion der Tiefe. Zu den verfügbaren Analysetechniken gehören unter anderem die folgenden:
Tof-ERDA zum Nachweis aller Elemente und verschiedener Wasserstoffisotope
SIMS zum Nachweis von Spurenmengen (ppm- bis ppb-Bereich) von Verunreinigungen an der Oberfläche und in verschiedenen Tiefen
GD-OES für schnelle quantitative Tiefenprofilierung ohne Vakuumkammer – fähig, leichte Elemente nachzuweisen
VPD-ICP-MS zur Bestimmung von Kontamination durch Spurenmetalle auf der Probenoberfläche
ToF-ERDA-Messung
SIMS-Messung
GD-OES-Messung
VPD-ICP-MS
Preise ohne MwSt.
Bestimmung physikalischer Eigenschaften
Wir bieten eine Reihe von Methoden zur Bestimmung der Dicke, Rauheit, Dichte und anderer physikalischer Eigenschaften von Dünnschichten und Wafern, die in der Halbleiterentwicklung verwendet werden. Zu den Testoptionen gehören unter anderem die folgenden:
Rauheitsmessungen mit Rasterkraftmikroskopie und optischer Profilometrie
Dickenmessungen mit Röntgenreflektometrie und Ellipsometrie
Kristallstrukturbestimmung mit GI-XRD
AFM-Oberflächenrauheitsmessung
XRR von Dünnschichten oder Beschichtungen
GI-XRD von Dünnschichtfilmen
Ellipsometrische Messung
Preise ohne MwSt.
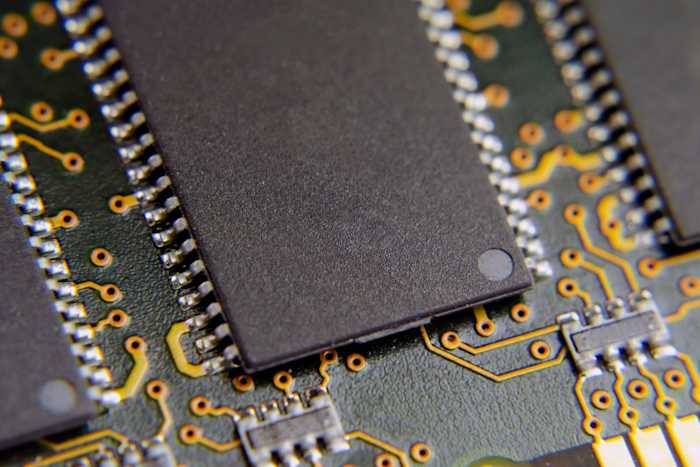
Mechanische und thermische Prüfung
Unsere Serviceauswahl umfasst verschiedene Messungen zur Bewertung der Haltbarkeit von Mikroelektronik, Leiterplatten, elektrischen Geräten und Komponenten unter festgelegten mechanischen Belastungen und Temperaturbedingungen. Dazu gehören folgende Prüfungen:
Dies sind nur einige Beispiele für unsere Möglichkeiten, zögern Sie also nicht, uns nach weiteren Tests zu fragen.
Ein Partner für alle Ihre Halbleiter-Testbedürfnisse
Wenn Sie Halbleiterprüfdienstleistungen bei Measurlabs beauftragen, erhalten Sie Zugang zu einer breiten Palette von Techniken an einem Ort, zuverlässige und klare Ergebnisse sowie Unterstützung durch qualifizierte Experten, die Verantwortung für Ihre aktuellen und zukünftigen Prüfprojekte bei uns übernehmen. Zögern Sie nicht, uns zu kontaktieren, um mehr zu erfahren.
Angebot anfordern
Füllen Sie das Formular aus und wir antworten Ihnen innerhalb eines Werktages.
Haben Sie Fragen oder brauchen Hilfe? Schreiben Sie uns unter info@measurlabs.com oder rufen Sie unser Vertriebsteam an.
