Röntgenreflektometrie
Die Röntgenreflektometrie (XRR) ist ein zerstörungsfreies Analyseverfahren zur Bestimmung der Dicke, Dichte und Oberflächenrauheit von dünnen Schichten und Beschichtungen. XRR ist sowohl für einschichtige als auch für mehrschichtige Strukturen anwendbar, da es Informationen über die Dicke und Dichte einzelner Schichten sowie die Rauheit der Zwischenphasen und der obersten Oberfläche liefert.
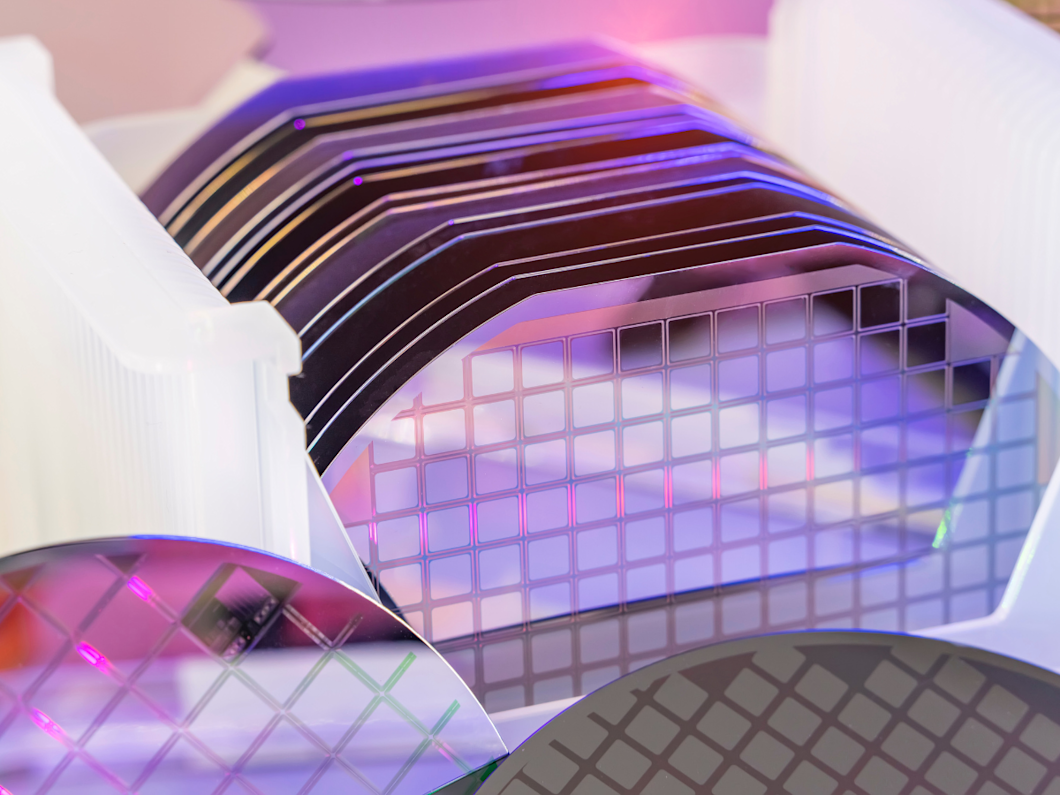
Einige unserer XRR-Dienstleistungen
XRR von Dünnschichten oder Beschichtungen
XRR + GI-XRD von Dünnschichten
Preise ohne MwSt.
Wozu dient die XRR-Analyse?
Die Röntgenreflektometrie (XRR) ist eine gängige Dünnschicht-Charakterisierungstechnik. Mit XRR lassen sich die Dicke, Dichte und Rauheit von Dünnschichten bestimmen.
XRR eignet sich für die Charakterisierung einer großen Vielfalt von Dünnschichten, darunter Metalloxide, Metalle und organische Schichten. Die untersuchten Schichten können mit verschiedenen Verfahren abgeschieden werden, darunter Chemical Vapor Deposition (CVD), Atomic Layer Deposition (ALD), Physical Vapor Deposition (PVD) und andere ähnliche Techniken. Sowohl einlagige Dünnschichten als auch mehrlagige Schichtstapel auf typischen Substraten wie Silizium (Si), Galliumnitrid (GaN), Siliziumkarbid (SiC), Galliumarsenid (GaAs) oder Indiumphosphid (InP)-Wafern können analysiert werden. Die Röntgenreflektometrie eignet sich für die Charakterisierung kristalliner und amorpher Dünnschichten. Die Eigenschaften der Materialoberfläche und der Grenzflächen der Schichten können bestimmt werden.
Ein Beispiel für XRR-Ergebnisse ist in Tabelle 1 dargestellt. Bei der untersuchten Probe handelt es sich um eine Al2O3-Dünnschicht, die auf einem Siliziumwafer mit einer nativen Oxidschicht abgeschieden wurde. Die Dicke, Dichte und Oberflächenrauheit beider Schichten wurden bestimmt.

Die Bestimmung der Schichtdicke mit XRR ist im Allgemeinen für Schichten mit einer Dicke von einigen Nanometern bis 150 Nanometern zuverlässig. Bei Schichten, die dicker als 150 nm sind, können Dichte und Oberflächenrauheit noch genau gemessen werden, aber die Dickenbestimmung wird weniger zuverlässig. Eine glatte Oberfläche erhöht die Genauigkeit der XRR-Messungen, wobei Proben mit einer RMS-Rauheit unter 5 nm im Allgemeinen als gut geeignet für die Analyse gelten.
Was ist das Funktionsprinzip von XRR?
Bei einer XRR-Analyse wird eine Probe mit einem Röntgenstrahl unter einem sehr flachen, „streifenden“ Einfallswinkel bestrahlt. Wenn die Röntgenstrahlen auf die Probe treffen, wechselwirken sie mit den Elektronen des Materials und werden an der Oberfläche reflektiert. Das XRR-Gerät misst die Intensität dieser reflektierten Röntgenstrahlung, während der Einfallswinkel variiert wird, und erzeugt so ein Diagramm der Reflektivität in Abhängigkeit vom Winkel (Abbildung 1).
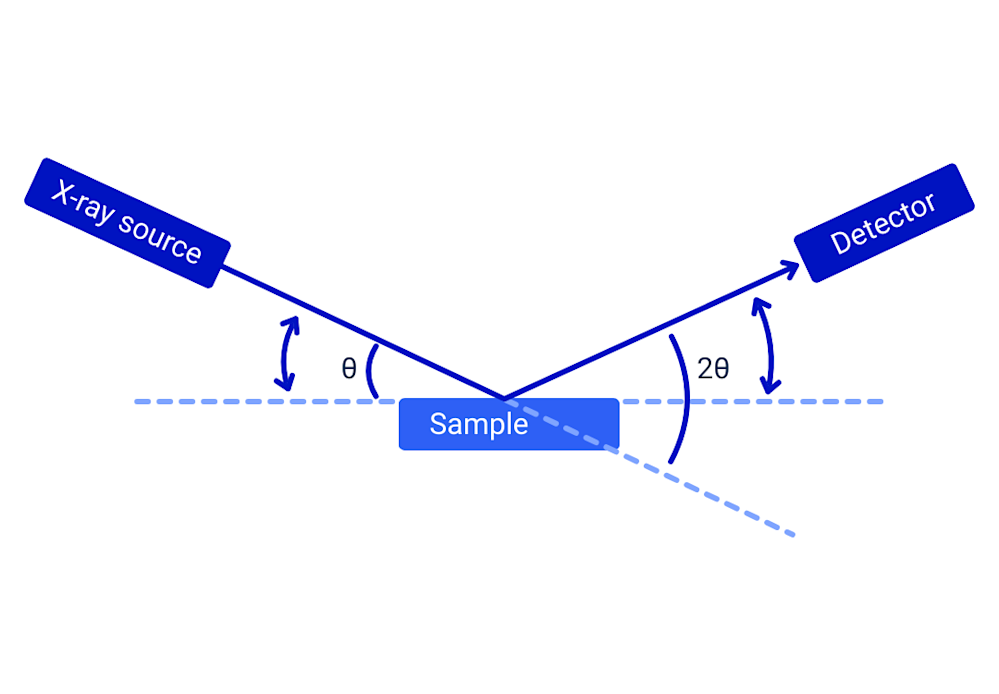
Jedes Material besitzt einen spezifischen kritischen Winkel, der durch seine Elektronendichte bestimmt wird. Unterhalb dieses Winkels werden einfallende Röntgenstrahlen hauptsächlich totalreflektiert, wobei die Eindringtiefe minimal ist (einige Nanometer). Oberhalb des kritischen Winkels nimmt die Eindringtiefe erheblich zu, während die Intensität der reflektierten Röntgenstrahlen stark abfällt.
Bei Proben mit dünnen Filmen oder Beschichtungen auf einem Substrat werden Röntgenstrahlen nicht nur von der Oberfläche reflektiert, sondern auch von den Grenzflächen zwischen verschiedenen Schichten (überall dort, wo sich die Materialdichte ändert). Da Röntgenstrahlen, die von tieferen Grenzflächen reflektiert werden, einen längeren Weg zurücklegen, interferieren sie mit denen, die von darüber liegenden Oberflächen reflektiert werden. Diese Interferenz, bei der sich die Röntgenwellen entweder verstärken oder auslöschen, erzeugt ein charakteristisches Oszillationsmuster in den gemessenen Röntgenreflektometriedaten (Abbildung 2).

Durch Analyse der Merkmale der XRR-Reflexionskurve können die folgenden Parameter bestimmt werden:
Dichte - wird aus der Position des kritischen Winkels berechnet.
Schichtdicke - Bestimmt aus dem Abstand der Interferenzstreifen.
Oberflächen- und Grenzflächenrauheit - Abgeleitet daraus, wie schnell die Gesamtreflektivität mit zunehmendem Winkel abnimmt und wie gedämpft die Schwingungen sind. Eine glattere Oberfläche führt zu einem stärkeren Abfall nach dem kritischen Winkel und zu ausgeprägteren Schwingungen, während die Rauheit eine allmählichere Abnahme und schwächere Schwingungen verursacht.
Benötigen Sie eine XRR-Analyse?
Measurlabs bietet qualitativ hochwertige XRR-Analysen zu einem erschwinglichen Preis. Wir bieten Messungen mit verschiedenen Geräten an (mehr dazu auf der XRR-Service-Seite) und können auch große Probenmengen effizient bearbeiten. Unser Expertenteam ist immer für Sie da, wenn Sie Fragen zu Ihren Proben oder zur Eignung der Methode für Ihre Bedürfnisse haben.
Kontaktieren Sie uns über das untenstehende Formular, um ein Angebot zu erhalten – bitte beachten Sie, dass wir auch ein komplettes Spektrum anderer Analysen für Dünnschicht- und Wafercharakterisierung anbieten.
Methodenexperte
Passende Probenmatrizen
- CVD-Dünnschichten
- ALD-Dünnschichten
- PVD-Dünnschichten
- Dünne Schichten auf Si, GaN, SiC, GaAs und InP-Substraten
- Proben mit mehreren Filmen oder Schichten aus unterschiedlichen Materialien
- Halbleiter
- Optische Materialien
Ideale Anwendungen der XRR-Analyse
- Bestimmung der Dicke, Dichte und Rauheit von dünnen Materialien und Einzelschichten in Schichtstapeln
- Untersuchung der Eigenschaften der Oberfläche und möglicher Grenzflächen von Materialien
- Analysen der strukturellen Eigenschaften sehr dünner Einzelschichten und Beschichtungen
- Forschung und Produktentwicklung sowie Qualitätskontrolle und Optimierung der Produktionsprozesse
Fragen Sie nach einem Angebot
Füllen Sie das Formular aus und wir antworten Ihnen innerhalb eines Werktages.
Haben Sie Fragen oder brauchen Hilfe? Schreiben Sie uns unter info@measurlabs.com oder rufen Sie unser Vertriebsteam an.
Häufig gestellte Fragen
XRR wird üblicherweise zur Untersuchung der strukturellen Eigenschaften von Materialien verwendet, die aus einer einzelnen Schicht oder einem Stapel mehrerer Schichten bestehen, z. B. ALD- oder MLD-abgeschiedene Schichten. Die Parameter, wie Dicke und Dichte der einzelnen Schichten des Materials, können bestimmt werden. Auch die Rauheit der Oberfläche und der Grenzflächen der verschiedenen Schichten des Materials kann ermittelt werden. Weiterhin lassen sich die Korrelationseigenschaften von Grenzflächen oder lateraler Schichtstrukturen aus den Daten ableiten.
Diese Charakterisierung von Materialien kann eine große Hilfe für die Forschung und Produktentwicklung sowie für die Prozessoptimierung und Qualitätskontrolle sein.
Die elementare Zusammensetzung der Probe kann mit XRR nicht bestimmt werden, daher sollten die Elemente, aus denen das Material besteht, im Voraus ermittelt werden. Neben dem Material muss auch dessen ungefähre Dicke vor der Analyse bekannt sein, da nur Schichten mit einer Dicke von weniger als 5000 Nanometern untersucht werden können.
Mögliche laterale Inhomogenitäten können mit XRR nicht erfasst werden, sodass ein mit dieser Technik erstelltes Modell der Probe diese Eigenschaften nicht berücksichtigt.
Die Eigenschaften auf Teilchenebene, wie Kristallstruktur und Gitterparameter, von Dünnfilmen, Schichten und Beschichtungen können nicht mit XRR analysiert werden. Stattdessen ist die Röntgenbeugung unter streifendem Einfall (GIXRD) eine geeignete Methode für diesen Zweck.
Mit XRR analysierte Materialien können beispielsweise Halbleiter, magnetische oder optische Materialien sein. XRR funktioniert am besten, wenn die Probe glatt, gleichmäßig und flach ist und eine Rauheit von weniger als 2 Nanometern aufweist. Die gesamte Dicke des Films, der untersucht wird, muss weniger als 5.000 Nanometer betragen.
Die analysierten Proben können aus einer sehr dünnen Einzelschicht oder aus mehreren Schichten bestehen und unterschiedliche Arten von Beschichtungen aufweisen. Die einzelnen Filme können entweder aus Einkristallen, polykristallinem oder amorphem Material bestehen.
Measurlabs offers a variety of laboratory analyses for product developers and quality managers. We perform some of the analyses in our own lab, but mostly we outsource them to carefully selected partner laboratories. This way we can send each sample to the lab that is best suited for the purpose, and offer high-quality analyses with more than a thousand different methods to our clients.
When you contact us through our contact form or by email, one of our specialists will take ownership of your case and answer your query. You get an offer with all the necessary details about the analysis, and can send your samples to the indicated address. We will then take care of sending your samples to the correct laboratories and write a clear report on the results for you.
Samples are usually delivered to our laboratory via courier. Contact us for further details before sending samples.
