TXRF-Analyse
Totalreflexions-Röntgenfluoreszenz (TXRF) ist eine Elementaranalysetechnik, die zum Nachweis von Elementverunreinigungen in ultraniedrigen Konzentrationen auf glatten, ebenen Oberflächen eingesetzt wird. Sie wird hauptsächlich in der Halbleiterindustrie zur Analyse metallischer Verunreinigungen auf Wafern während der Prozessentwicklung und der Routineproduktion verwendet.

Wofür wird die TXRF-Analyse verwendet?
TXRF wird hauptsächlich zur Untersuchung metallischer Kontaminationen auf Wafern in der Halbleiterindustrie eingesetzt. Die Technik kann Elemente von Natrium (Na) bis Uran (U) bei Oberflächenkonzentrationen zwischen 109 und 1012 Atomen pro Quadratzentimeter nachweisen und ist damit eine der empfindlichsten Methoden für Untersuchungen von Spurenkontaminationen an Oberflächen.
Funktionsprinzip und Ergebnisse der TXRF
Das Funktionsprinzip der TXRF und die zugrunde liegende Röntgenfluoreszenz sind in Abbildung 1 dargestellt. Die TXRF-Analyse beginnt mit der Erzeugung eines monochromatischen Röntgenstrahls, der in einem sehr flachen Winkel, üblicherweise weniger als 0,5° bezogen auf die Oberflächenebene, auf die Probenoberfläche gerichtet wird. Dies bedeutet, dass der Strahl nur bis zur Oberfläche der Probe (~5 nm) eindringt und die darunter liegenden Strukturen die Oberflächenanalyse nicht beeinträchtigen.
Wenn der Röntgenstrahl auf die Oberfläche trifft, regt er die Atome an der Oberfläche an, indem er Elektronen mit niedrigem Energieniveau aus ihren inneren Elektronenschalen entfernt. Ein Elektron mit höherer Energie aus einer äußeren Elektronenschale fällt dann in die innere Elektronenschale, um die Leerstelle zu füllen. Dieses Fallen des Elektrons in die innere Schale führt zur Freisetzung sekundärer Röntgenstrahlen (Röntgenfluoreszenz). Diese sekundären Röntgenstrahlen haben charakteristische Energien, die auf den Atomen basieren, von denen sie emittiert werden. Der Nachweis der sekundären Röntgenstrahlen mit einem energiedispersiven Detektor ermöglicht die Bestimmung der jeweiligen Elemente und ihrer Konzentrationen in der Probe.
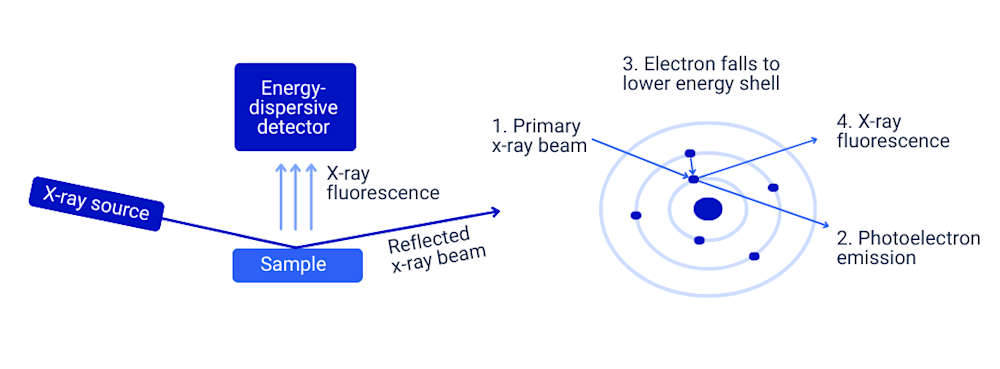
In einem typischen TXRF-Aufbau wird ein Wafer 40–300 TXRF-Messungen an einzelnen Stellen unterzogen, und die Konzentrationen verschiedener Verunreinigungselemente werden dann als zweidimensionale Wärmebilder dargestellt (Abbildung 2 unten).

Geeignete Proben und Anwendungsfälle
TXRF ist für blanke und beschichtete Wafer mit Größen von 100–300 mm geeignet. Praktisch alle gängigen Wafermaterialien wie Si, SiC, GaAs, GaN, InP und Glas sind für TXRF geeignet. Die Hauptanforderung für die TXRF-Analyse ist eine glatte Oberfläche, sodass Wafer mit dünnen Schichten, die mit typischen Abscheideverfahren wie ALD, CVD, PVD oder ähnlichen hergestellt wurden, untersucht werden können.
TXRF ist eine zerstörungsfreie Methode, sodass Wafer sowohl vor als auch nach bestimmten Fertigungsschritten analysiert werden können. Dies ermöglicht die Rückverfolgung von Kontaminationsquellen während der Halbleiterfertigung. Wenn beispielsweise ein Wafer vor dem Transport innerhalb der Fertigungsanlage eine vernachlässigbare Kontamination aufweist, danach jedoch lokalisiertes Eisen (Fe), Chrom (Cr) und Nickel (Ni) in der Nähe der Kanten zeigt, könnte eine Edelstahl-Waferklemme, die während des Transports verwendet wurde, als wahrscheinliche Kontaminationsquelle identifiziert werden.
Überlegungen und alternative Methoden
Aufgrund der extrem hohen Empfindlichkeit von TXRF für elementare Verunreinigungen müssen alle zur TXRF-Analyse versandten Proben sorgfältig in einen Wafer-Träger oder FOUP verpackt und in einem Reinraum in luftdichten Verpackungen versiegelt werden, um eine Kontamination während des Transports zu vermeiden.
Obwohl TXRF ein sehr leistungsfähiges Werkzeug zur Bestimmung metallischer Verunreinigungen auf Wafern ist und das Mapping einzigartige Möglichkeiten zur Identifizierung von Kontaminationsquellen im Produktionsprozess bietet, gehört die Methode zu den kostenintensivsten, die für die Kontaminationsanalyse eingesetzt werden. Das Mapping eines einzelnen Wafers kostet typischerweise zwischen 1.000 € und 10.000 €, abhängig von der Wafergröße, der Anzahl der gemessenen Punkte und der Anzahl der Proben.
Wenn eine Routinemethode für Untersuchungen der elementaren Oberflächenkontamination von Wafern benötigt wird, bietet VPD-ICP-MS (Dampfphasenzerlegung-induktiv gekoppelte Plasma-Massenspektrometrie) eine kostengünstige Alternative zu TXRF mit noch niedrigeren Nachweisgrenzen. Allerdings können mit VPD-ICP-MS keine Informationen über die Lokalisierung der Kontamination gewonnen werden. Sowohl TXRF als auch VPD-ICP-MS sind oberflächenempfindlich. Falls eine elementare Tiefenprofilierung angestrebt wird, müssen daher andere Methoden wie SIMS (Sekundärionen-Massenspektrometrie) verwendet werden. Für die Untersuchung organischer Kontaminationen ist ATD GC-MS (automatisierte Thermodesorption-Gaschromatographie-Massenspektrometrie) die Methode der Wahl.
TXRF vs. RFA
Grundsätzlich funktionieren Röntgenfluoreszenz (XRF) und TXRF auf die gleiche Weise. Der Unterschied ergibt sich daraus, dass der TXRF-Aufbau speziell darauf ausgelegt ist, die Menge an gestreuten und absorbierten Röntgenstrahlen zu reduzieren und stattdessen die Menge an Fluoreszenz zu maximieren. Dies wiederum erzeugt ein sehr hohes Signal-Rausch-Verhältnis und ermöglicht es der Technik, eine weitaus höhere Empfindlichkeit als die konventionelle XRF zu erreichen.
Der wesentliche Nachteil von TXRF im Vergleich zu konventioneller XRF ist die teure und große Instrumentierung, die für Erstere erforderlich ist. TXRF erfordert außerdem vollständig glatte Proben ohne partikuläre Verunreinigungen auf den Proben, während XRF zur Analyse nahezu jeder Art von festen oder flüssigen Proben ohne Anforderungen an Glätte oder Sauberkeit verwendet werden kann. Aufgrund dieser Unterschiede kann XRF zur Untersuchung der Elementzusammensetzung und Verunreinigungen verschiedener Proben mit minimaler Probenvorbereitung und Vorsichtsmaßnahmen eingesetzt werden, während TXRF praktisch nur in der Halbleiterindustrie anwendbar ist.
Benötigen Sie TXRF-Analysen?
Measurlabs bietet Labortests mit TXRF sowie mehrere andere Techniken (ToF-SIMS, VPD-ICP-MS usw.) für die Analyse von Verunreinigungen auf Spurenebene bei Dünnschichten und Wafern an. Wir bieten Optionen für Express-Bearbeitungszeiten für zeitkritische Projekte und können große Probenmengen effizient bearbeiten. Dank unseres umfassenden Spektrums an Techniken können Sie alle benötigten Analysen aus einer Hand beziehen. Kontaktieren Sie unsere Experten über das untenstehende Formular, um ein Angebot zu erhalten.
Methodenexperte
Passende Probenmatrizen
- Wafer (Si, SiC, GaAs, GaN, InP usw.)
- Dünnschichten
- Halbleiter
Ideale Anwendungen der TXRF
- Spurenelementbestimmung
- Wafer-Mapping
- Rückverfolgung von Kontaminationsquellen
Fragen Sie nach einem Angebot
Füllen Sie das Formular aus und wir antworten Ihnen innerhalb eines Werktages.
Haben Sie Fragen oder brauchen Hilfe? Schreiben Sie uns unter info@measurlabs.com oder rufen Sie unser Vertriebsteam an.
Häufig gestellte Fragen
Measurlabs offers a variety of laboratory analyses for product developers and quality managers. We perform some of the analyses in our own lab, but mostly we outsource them to carefully selected partner laboratories. This way we can send each sample to the lab that is best suited for the purpose, and offer high-quality analyses with more than a thousand different methods to our clients.
When you contact us through our contact form or by email, one of our specialists will take ownership of your case and answer your query. You get an offer with all the necessary details about the analysis, and can send your samples to the indicated address. We will then take care of sending your samples to the correct laboratories and write a clear report on the results for you.
Samples are usually delivered to our laboratory via courier. Contact us for further details before sending samples.
